LED作为高效且寿命长的光源,广泛应用于各类工业照明、汽车前大灯、显示器及指示灯等领域。然而,尽管LED的能效较白炽灯显著提升,但在工作时会产生大量的热量。若热量无法及时散出,结温升高将导致发光效率下降、波长红移、寿命缩短等问题。传统封装多采用陶瓷(如氮化铝AlN、氧化铝Al₂O₃)或金属(如铜)作为热扩散基板,但这些材料导热率有限(AlN约170–200 W/m·K,Al₂O₃约27 W/m·K,铜约400 W/m·K),在高功率密度(可达500 W/cm²)下仍难以满足散热需求。
深圳技术大学研究团队针对高功率LED散热瓶颈,提出了一种采用单晶金刚石作为热扩散器的封装方案,通过优化界面键合技术,显著降低了热阻,提升了器件散热能力,为高功率LED及其他电子器件提供了高效热管理路径。相关成果以“Enhanced thermal performances of high-power LED by diamond packaging”为题,发表在《Diamond & Related Materials》。
研究团队选用单晶金刚石(SCD)作为热扩散器。单晶金刚石室温导热率高达约2000 W/m·K,远超传统材料,且热膨胀系数低(0.8–4.0 × 10⁻⁶ K⁻¹),与GaN半导体更匹配,有望降低热应力。研究对比了三种尺寸均为5 mm × 5 mm × 0.5 mm的热扩散基板:单晶金刚石、AlN和Al₂O₃,搭配同一款商用高功率LED芯片(额定电流3 A)进行封装与测试。
为解决金刚石表面惰性、难以直接金属化的难题,团队开发了一种先进键合工艺:首先对金刚石表面进行Ar离子轰击激活清洗,去除污染物并活化表面;随后通过磁控溅射依次沉积TiC过渡层(约100 nm厚)、Cu导热层(约3 µm)和Au焊接层(约1 µm);再经500 ℃真空退火强化界面;最后采用Au₈₀Sn₂₀共晶焊料将LED芯片键合至金属化金刚石基板。AlN和Al₂O₃基板也采用相同金属化和键合流程,以确保对比公平。
实验结果显示,金刚石封装的散热性能大幅领先。在3 A工作电流下,金刚石组LED芯片最高温度仅55.8 ℃,而AlN组为74.9 ℃,Al₂O₃组高达128.6 ℃——金刚石将结温分别降低了19.1 ℃和72.8 ℃。热红外成像清晰显示,金刚石基板热量分布更均匀,几乎无明显热点,而Al₂O₃基板热量高度集中于芯片区域。
该研究表明,通过Ar离子激活+TiC过渡层+共晶键合的金刚石封装策略,可大幅降低高功率LED热阻、抑制热点、提升器件可靠性与功率密度。这一成果不仅适用于LED,还可扩展至激光二极管(LD)及其他高功率电子器件,为下一代高性能电子设备的热管理提供了重要参考。
图文导读
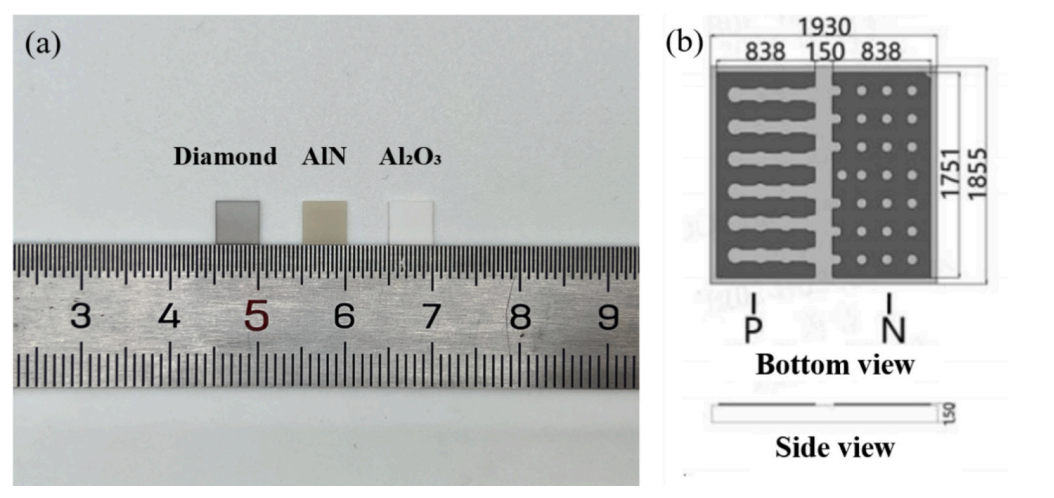
图1. (a) 基底材料照片(从左至右依次为)金刚石、氮化铝和氧化铝基底。
(b) LED芯片示意图(单位为微米),展示底部视图与侧面视图。侧面视图标注了LED芯片的厚度。
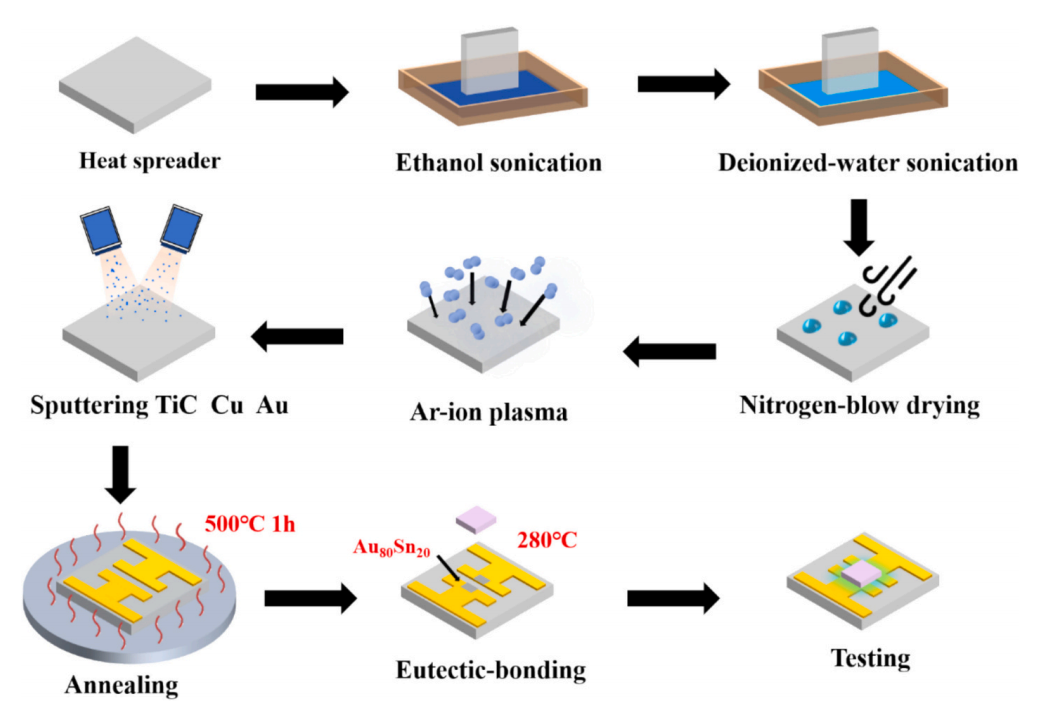
图2. 采用金刚石散热器的功率型LED封装。
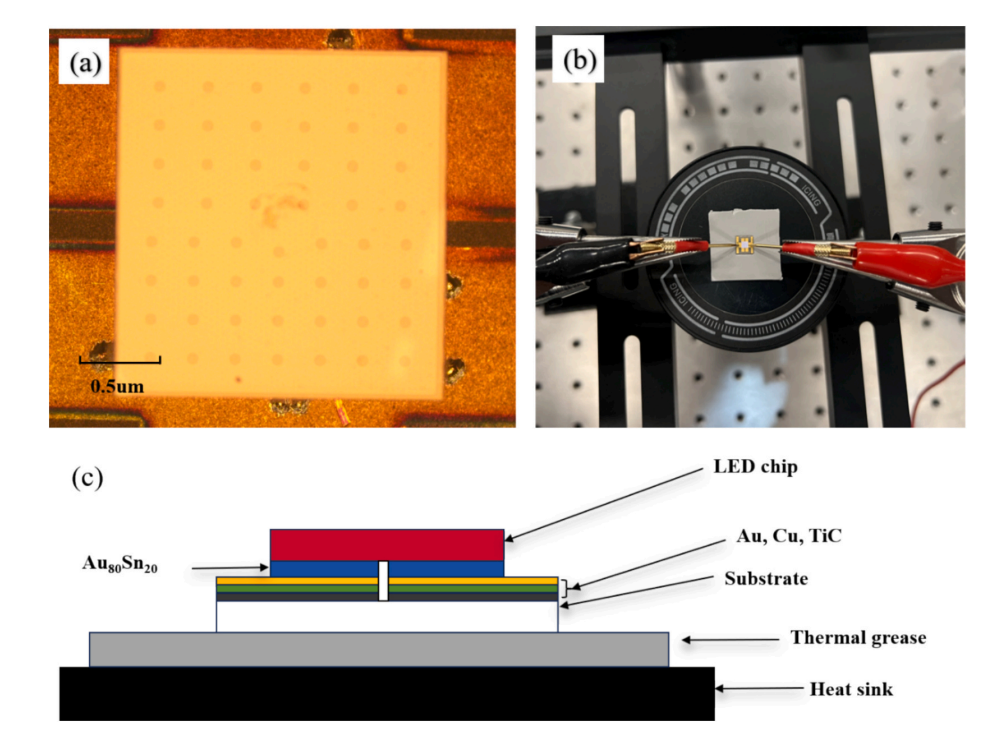
图3. (a) LED芯片的显微图像。(b) LED测试装置的俯视照片,显示散热器(白色)、位于散热器中心的LED芯片以及为LED供电的导线。(c) 测试装置示意侧视图。基板指代散热片材质(金刚石、氮化铝或氧化铝)。示意图未按比例绘制。
来源:DT半导体材料